엔비디아의 베라 루빈 슈퍼칩 실시간 이미지.

엔비디아는 화요일 DC에서 열린 GTC 2025 기조연설에서 AI 및 HPC용 두 개의 루빈(Rubin) GPU와 자체 개발한 88코어 베라(Vera) CPU를 포함하는 차세대 베라 루빈 슈퍼칩(Vera Rubin Superchip)을 공개했습니다. 엔비디아에 따르면 이 세 가지 핵심 구성 요소 모두 내년 이맘때부터 양산에 들어갈 예정입니다.

엔비디아의 젠슨 황(Jensen Huang) 최고경영자(CEO)는 GTC에서 "이것이 차세대 루빈입니다"라고 말했습니다. 그는 "현재 GB300을 출하하고 있지만, 루빈을 내년 이맘때쯤, 어쩌면 조금 더 일찍 생산할 수 있도록 준비하고 있습니다. […] 정말 놀라운 컴퓨터입니다. 즉, AI용 100 페타플롭스(PetaFLOPS)[FP4 성능]를 구현한 것입니다"라고 덧붙였습니다.
실제로 엔비디아의 슈퍼칩은 범용 맞춤형 CPU와 AI 및 HPC 워크로드를 위한 두 개의 고성능 컴퓨팅 GPU를 탑재하고 있어, 단순히 ‘칩’이라기보다는 매우 두꺼운 PCB에 구현된 마더보드 형태에 가깝습니다. 베라 루빈 슈퍼칩 역시 예외가 아니며, 이 보드는 LPDDR 메모리가 장착된 SOCAMM2 메모리 모듈로 둘러싸인 차세대 88코어 베라 CPU와 두 개의 루빈 GPU가 크고 직사각형의 알루미늄 히트 스프레더로 덮여 있는 구조입니다.
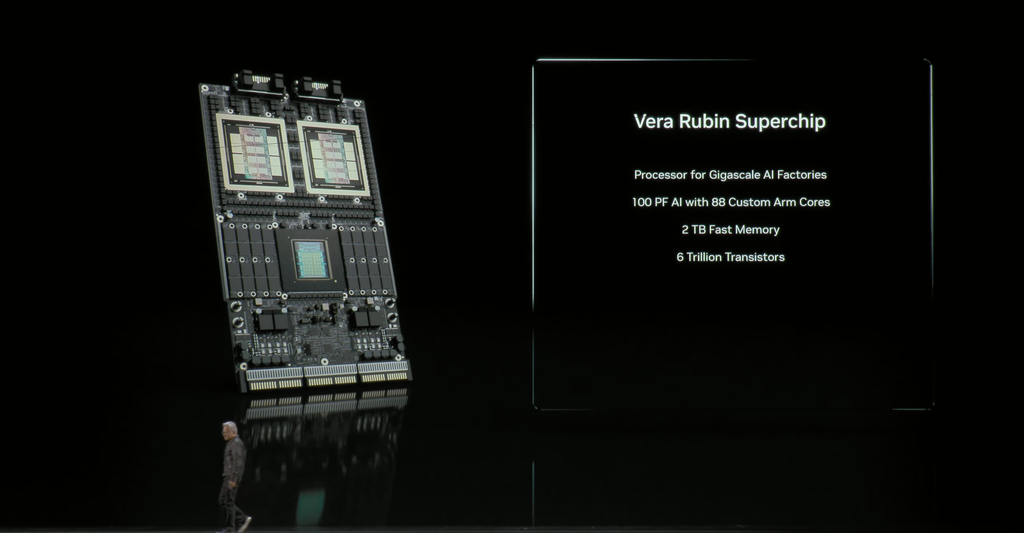
루빈 GPU에 새겨진 표시를 보면 이 GPU들이 2025년 38번째 주, 즉 9월 말에 대만에서 패키징되었다고 나와 있습니다. 이는 회사가 이 신형 프로세서에 대해 상당한 기간 동안 연구 및 개발을 진행해 왔음을 증명합니다. 히트 스프레더 크기는 블랙웰(Blackwell) 프로세서와 유사하여 GPU 패키지나 컴퓨팅 칩렛의 정확한 크기는 파악하기 어렵습니다. 한편, 베라 CPU는 눈에 띄는 내부 이음매(seams)가 관찰되어 단일(monolithic) 구조가 아니며, 이는 다중 칩렛(multi-chiplet) 설계임을 시사합니다.
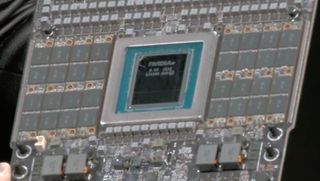
엔비디아가 시연한 보드 사진은 각 루빈 GPU가 두 개의 컴퓨팅 칩렛, 8개의 HBM4 메모리 스택, 그리고 하나 또는 두 개의 I/O 칩렛으로 구성되어 있음을 다시 한번 보여줍니다. 주목할 만한 점은, 이번에 엔비디아는 매우 뚜렷한 I/O 칩렛이 옆에 위치한 베라 CPU를 시연했다는 것입니다. 또한 이미지에는 CPU 다이의 I/O 패드에서 나오는 녹색 특징들이 보이는데, 그 용도는 알려지지 않았습니다. 이는 베라의 일부 I/O 기능이 CPU 자체 아래에 위치한 외부 칩렛에 의해 활성화될 가능성을 제시합니다. 당연히 추측이지만, 베라 프로세서에는 확실히 흥미로운 기술적 요소들이 존재합니다.

흥미롭게도, 베라 루빈 슈퍼칩 보드는 업계 표준 케이블 커넥터 슬롯이 없습니다. 대신, GPU를 NVLink 스위치에 연결하는 두 개의 NVLink 백플레인 커넥터가 상단에 배치되어 랙(rack) 내 스케일업(scale-up) 확장을 지원하며, 하단 가장자리에는 전원(power), PCIe, CXL 등을 위한 세 개의 커넥터가 위치합니다.
종합적으로 볼 때, 엔비디아의 베라 루빈 슈퍼칩 보드는 기술적 완성도가 매우 높은 것으로 보입니다. 따라서 해당 장치는 2026년 후반경 출하되어 2027년 초에 실제 배치될 것으로 예상됩니다.

최신 뉴스, 분석 및 리뷰를 피드에서 받으려면 Google News의 Tom's Hardware를 팔로우하거나, 저희를 즐겨찾는 출처로 추가해 주세요.